一、项目背景
晶圆作为半导体芯片的基础载体,其厚度的精确控制直接影响到芯片的性能、可靠性和最终产品的成品率。通过准确的晶圆厚度测量,可以确保芯片在制造过程中的稳定性和一致性,从而提高产品的整体质量。
深视智能SCI系列光谱共焦位移传感器具有高精度、高分辨率的特点,无惧各种材质、形状测量,能快速、稳定测量晶圆厚度变化,确保晶圆的厚度符合严格的设计标准。
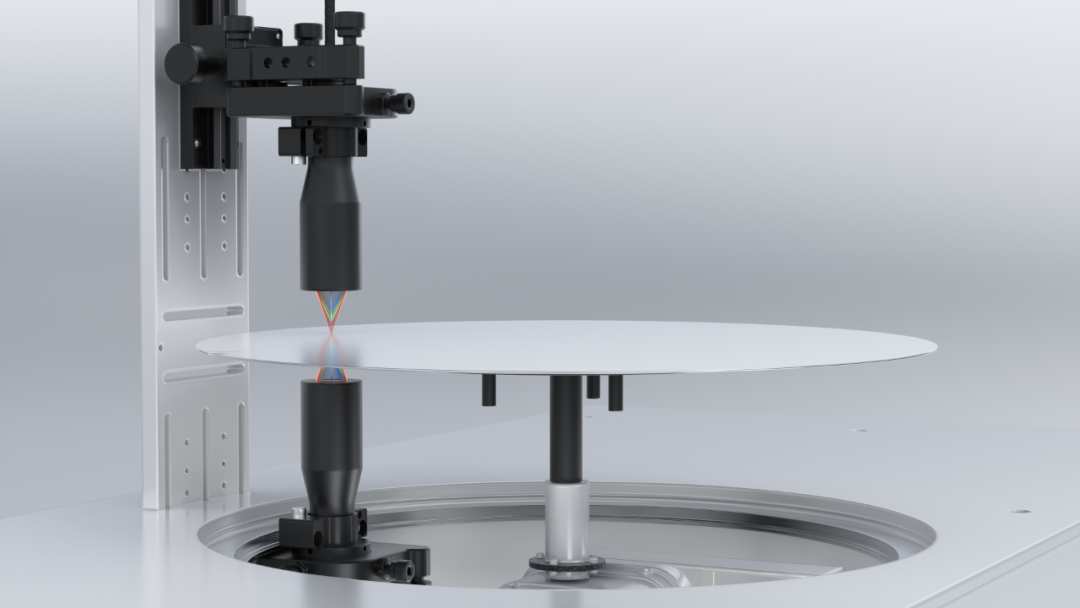
图 | 晶圆对射测厚
二、检测需求

被测工件:晶圆
测量项目:厚度
精度要求:1μm
三、晶圆对射测厚方案
半导体晶圆器件通常由多层薄膜组成,每一层的材料和结构都可能不同。SCI系列光谱共焦位移传感器拥有极高的稳定性能,可以实现对晶圆厚度的微米级测量,能轻松应对高透明、高反光、低反射率、粗糙等不同形状和材质的物料,解决因各种材质影响而导致信号无法稳定回传的难题。

采用激光对射的方式将两个深视智能SCI04025光谱共焦位移传感器分别安装到晶圆的上方和下方,选取晶圆片上的2个点进行测试,计算出晶圆片的厚度。通过载物台移动模拟自动实时测量,测试晶圆片的厚度变化。

数据结果:经过10次动态测量,晶圆厚度重复性最大为0.6μm。
SCI系列光谱共焦位移传感器能够实现对晶圆厚度的实时监测,将测量数据实时反馈给生产控制系统,从而实现对工艺参数的实时调整和优化。这有助于提高半导体制造的自动化程度和生产效率,降低生产成本和浪费。
四、深视智能传感器推荐

深视智能SCI系列光谱共焦位移传感器以其高稳定性、高精度、高分辨率的测量能力,确保了晶圆厚度的精准控制,为半导体器件的性能优化、质量提升及生产效率的提高提供了坚实的技术支撑。














 对比
对比 清空对比栏
清空对比栏
